

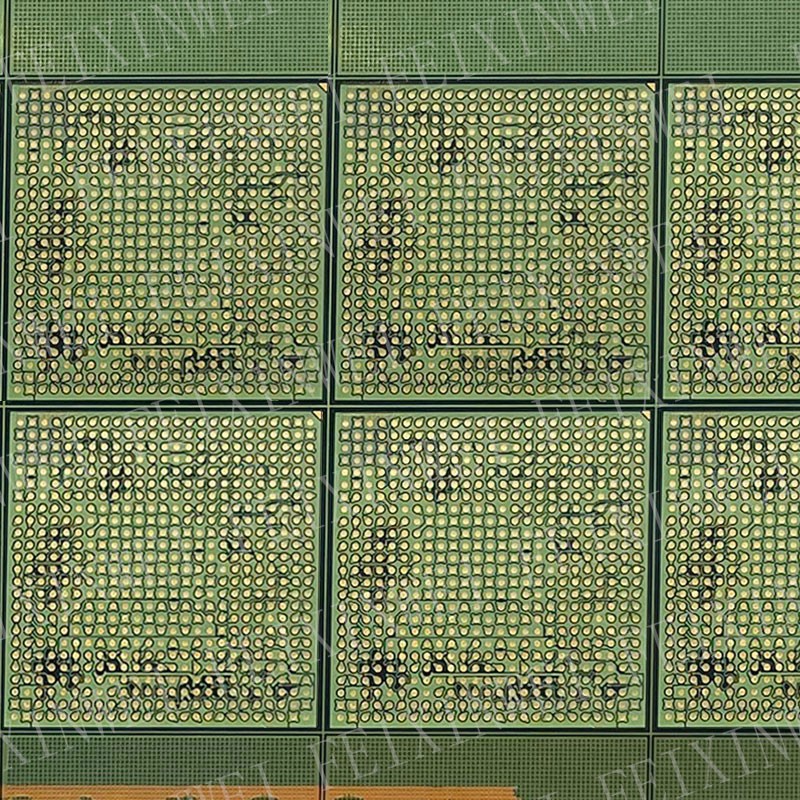
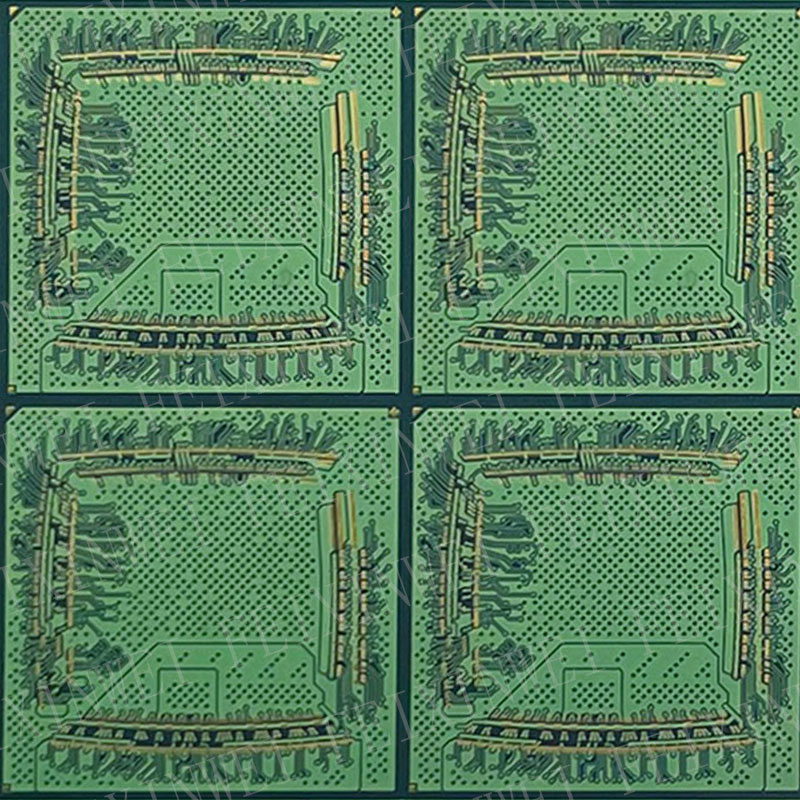


BGA封装特性
BGA(球栅阵列)封装通过底部矩阵式焊球实现高密度互连,适用于高I/O需求的芯片。其核心优势在于缩小封装体积、提升散热性及电性能。
引线键合(Wire Bonding)应用场景
虽然BGA封装通常以焊球直接连接基板,但在某些复杂封装中(如多芯片模块或射频组件),仍需通过引线键合实现芯片与基板的局部电气连接。引线键合采用金线或铜线,通过热超声工艺实现微观焊点形成,适用于高精度信号传输需求。
工艺原理与优势
镍层:作为扩散阻挡层,厚度控制在±0.03μm内,防止铜迁移并提升焊盘附着力。
钯层:0.05–0.15μm的活化层,减少镍氧化,优化焊料润湿性,提升焊点强度至45MPa以上(行业平均35MPa)。
金层:提供抗氧化表面,保障引线键合可靠性,适用于高密度金线键合场景。
适配先进封装需求
镍钯金工艺通过镀层精度控制与环保优化(如无氰镀液),满足BGA封装对焊盘平整度、信号完整性及长期可靠性的严苛要求。
材料与结构设计
BT树脂基材:兼具高耐热性(Tg≥180°C)与低介电常数(Dk≤3.5),适用于高频信号传输。
超薄多层设计:支持40μm线宽/间距布线,满足高密度互联需求,适配3D封装及混合键合技术。
应用场景
该基板专为BGA、CSP等先进封装设计,可承载高功耗芯片(如CPU/GPU),并通过铜柱凸块实现低阻抗、高散热性能。
核心作用
芯片载板为裸芯片提供机械支撑、电气连接及热管理,其高密度布线能力(线宽≤45μm)直接决定封装集成度。
技术门槛
与传统PCB相比,芯片载板需满足更高精度(层间对位误差≤3μm)、更低热膨胀系数(CTE≤8ppm/°C)及更高信赖性(耐温循环≥1000次)。
BGA封装通过焊球矩阵实现高密度互连,搭配镍钯金工艺可优化焊盘可靠性;三菱HL系列基板凭借BT树脂与超薄设计,适配先进封装需求。在复杂封装场景中,引线键合仍为关键局部互联手段,镍钯金的精密镀层控制保障其长期稳定性。