

飞芯微IC载板制程能力
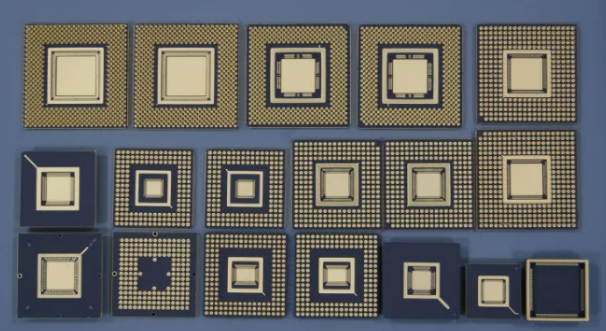
| 无卤树脂材料Non-haloganated Low CTE BT Resin Laminate | MITSUBISHI HL832NXA,HL832NS,HL832NSR(LC) |
| DS-7409HGB(S),DS-7409HGB(LE),DS-7409HGB(X) | |
| R1515E/R1515H,SI643HU,Shengyi SI10U(S),SI09U,SI07U,SI05U | |
| 基材厚度CCL thickness | 0.03, 0.04, 0.05, 0.06, 0.1, 0.15, 0.2, 0.25, 0.3, 0.35, 0.4, 0.45, 0.5, 0.6, 0.7, 0.8 |
| PP厚度Prepreg Thickness | 0.015-0.1mm |
| 层数Layers | Double layer 0.1mm |
| 4layer 0.24mm | |
| 6layer 0.4mm | |
| 8layer 0.6mm | |
| 最小过孔Min.Vias | Mechanical Drilling:0.1mm+/-0.05mm |
| Laser Drilling:0.05mm+/-0.025mm | |
| 最小盲孔/焊盘 Min.Blind Vias/PAD | 50um,100um |
| 最小线宽线距Min.Line width/Spacing | 40um/40um |
| 阻焊Solder Resist | EG23A,AUS308,AUS320,AUS410,SR1,SR2,SR3 |
| Surface finished | AU Plating(40U”),Immersion NiPdAu,ENIG,OSP,Immersion Tin/Silver |
| Technique Process | Tenting,Etch back,MSAP |
| Typical applications | CSP,FC-CSP,LGA,SIP,FMC,PBGA,FPGA,EMMC,SSD,DDR,LED MINI,USB3.0,MEMS |